
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
Nozzle CVD SiC ເຄືອບ
Nozzles ເຄືອບ CVD SiC ຂອງ Vetek Semiconductor ແມ່ນອົງປະກອບທີ່ສໍາຄັນທີ່ໃຊ້ໃນຂະບວນການ LPE SiC epitaxy ສໍາລັບການຝາກວັດສະດຸ silicon carbide ໃນລະຫວ່າງການຜະລິດ semiconductor. ທໍ່ຫົວເຫຼົ່ານີ້ປົກກະຕິແລ້ວແມ່ນເຮັດດ້ວຍວັດສະດຸ silicon carbide ທີ່ມີອຸນຫະພູມສູງແລະມີຄວາມຫມັ້ນຄົງທາງເຄມີເພື່ອຮັບປະກັນຄວາມຫມັ້ນຄົງໃນສະພາບແວດລ້ອມການປຸງແຕ່ງທີ່ຮຸນແຮງ. ອອກແບບມາສໍາລັບການປະທັບຕາເປັນເອກະພາບ, ພວກເຂົາເຈົ້າມີບົດບາດສໍາຄັນໃນການຄວບຄຸມຄຸນນະພາບແລະຄວາມເປັນເອກະພາບຂອງຊັ້ນ epitaxial ປູກໃນຄໍາຮ້ອງສະຫມັກ semiconductor. ຫວັງວ່າຈະສ້າງຕັ້ງການຮ່ວມມືໃນໄລຍະຍາວກັບທ່ານ.
ສົ່ງສອບຖາມ
VeTek Semiconductor ເປັນຜູ້ຜະລິດພິເສດຂອງອຸປະກອນເສີມການເຄືອບ CVD SiC ສໍາລັບອຸປະກອນ epitaxial ເຊັ່ນ CVD SiC Coating halfmoon parts ແລະອຸປະກອນເສີມຂອງມັນ CVD SiC Coating Nozzels.Welcome to inquiry us.
PE1O8 ແມ່ນລະບົບຕ່ອງໂສ້ອັດຕະໂນມັດຢ່າງເຕັມສ່ວນກັບລະບົບຕະຫລັບຫມຶກທີ່ຖືກອອກແບບມາເພື່ອຈັດການSiC wafersເຖິງ 200 ມມ. ຮູບແບບສາມາດປ່ຽນໄດ້ລະຫວ່າງ 150 ແລະ 200 ມມ, ຫຼຸດຜ່ອນເວລາການຢຸດເຄື່ອງ. ການຫຼຸດລົງຂອງຂັ້ນຕອນການໃຫ້ຄວາມຮ້ອນເພີ່ມຜົນຜະລິດ, ໃນຂະນະທີ່ອັດຕະໂນມັດຫຼຸດຜ່ອນແຮງງານແລະປັບປຸງຄຸນນະພາບແລະການເຮັດຊ້ໍາອີກ. ເພື່ອຮັບປະກັນຂະບວນການ epitaxy ທີ່ມີປະສິດທິພາບແລະມີການແຂ່ງຂັນດ້ານຄ່າໃຊ້ຈ່າຍ, ສາມປັດໃຈຕົ້ນຕໍແມ່ນໄດ້ຖືກລາຍງານ:
● ຂະບວນການໄວ;
● ຄວາມເປັນເອກະພາບສູງຂອງຄວາມໜາ ແລະຝຸ່ນ;
● ການຫຼຸດຜ່ອນການສ້າງຂໍ້ບົກພ່ອງໃນລະຫວ່າງຂະບວນການ epitaxy.
ໃນ PE1O8, ມະຫາຊົນ graphite ຂະຫນາດນ້ອຍແລະລະບົບການໂຫຼດ / unload ອັດຕະໂນມັດຊ່ວຍໃຫ້ການແລ່ນມາດຕະຖານສໍາເລັດໃນເວລາຫນ້ອຍກວ່າ 75 ນາທີ (ຮູບແບບມາດຕະຖານ Schottky 10μmໃຊ້ອັດຕາການເຕີບໂຕຂອງ 30μm / h). ລະບົບອັດຕະໂນມັດອະນຸຍາດໃຫ້ໂຫຼດ / unloading ໃນອຸນຫະພູມສູງ. ດັ່ງນັ້ນ, ເວລາເຮັດຄວາມຮ້ອນແລະຄວາມເຢັນແມ່ນສັ້ນ, ໃນຂະນະທີ່ຂັ້ນຕອນການອົບໄດ້ຖືກຂັດຂວາງ. ເງື່ອນໄຂທີ່ເຫມາະສົມນີ້ອະນຸຍາດໃຫ້ການຂະຫຍາຍຕົວຂອງວັດສະດຸທີ່ບໍ່ມີການຢຸດເຊົາທີ່ແທ້ຈິງ.
ໃນຂະບວນການຂອງ silicon carbide epitaxy, CVD SiC Coating Nozzles ມີບົດບາດສໍາຄັນໃນການເຕີບໂຕແລະຄຸນນະພາບຂອງຊັ້ນ epitaxial. ນີ້ແມ່ນຄໍາອະທິບາຍຂະຫຍາຍຂອງບົດບາດຂອງ nozzles ໃນຊິລິຄອນ carbide epitaxy:
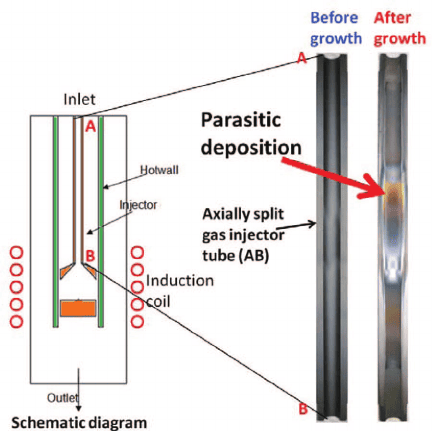
● ການສະໜອງ ແລະການຄວບຄຸມອາຍແກັສ: Nozzles ຖືກນໍາໃຊ້ເພື່ອສົ່ງປະສົມອາຍແກັສທີ່ຕ້ອງການໃນລະຫວ່າງການ epitaxy, ລວມທັງອາຍແກັສແຫຼ່ງຊິລິໂຄນແລະອາຍແກັສແຫຼ່ງກາກບອນ. ໂດຍຜ່ານ nozzles, ການໄຫຼຂອງອາຍແກັສແລະອັດຕາສ່ວນສາມາດຄວບຄຸມໄດ້ຊັດເຈນເພື່ອຮັບປະກັນການຂະຫຍາຍຕົວເປັນເອກະພາບຂອງຊັ້ນ epitaxial ແລະອົງປະກອບທາງເຄມີທີ່ຕ້ອງການ.
● ການຄວບຄຸມອຸນຫະພູມ: Nozzles ຍັງຊ່ວຍໃນການຄວບຄຸມອຸນຫະພູມພາຍໃນເຄື່ອງປະຕິກອນ epitaxy ໄດ້. ໃນ epitaxy silicon carbide, ອຸນຫະພູມແມ່ນປັດໃຈສໍາຄັນທີ່ມີຜົນກະທົບຕໍ່ອັດຕາການເຕີບໂຕແລະຄຸນນະພາບຂອງຜລຶກ. ໂດຍການສະຫນອງຄວາມຮ້ອນຫຼືອາຍແກັສເຢັນໂດຍຜ່ານ nozzles, ອຸນຫະພູມການຂະຫຍາຍຕົວຂອງຊັ້ນ epitaxial ສາມາດປັບໄດ້ສໍາລັບເງື່ອນໄຂການຂະຫຍາຍຕົວທີ່ດີທີ່ສຸດ.
● ການແຈກຢາຍການໄຫຼຂອງອາຍແກັສ: ການອອກແບບຂອງ nozzles ມີອິດທິພົນຕໍ່ການແຜ່ກະຈາຍຂອງອາຍແກັສເປັນເອກະພາບພາຍໃນເຕົາປະຕິກອນ. ການແຜ່ກະຈາຍຂອງອາຍແກັສທີ່ເປັນເອກະພາບຮັບປະກັນຄວາມສອດຄ່ອງຂອງຊັ້ນ epitaxial ແລະຄວາມຫນາທີ່ສອດຄ່ອງ, ຫຼີກເວັ້ນບັນຫາທີ່ກ່ຽວຂ້ອງກັບຄຸນນະພາບຂອງວັດສະດຸທີ່ບໍ່ສອດຄ່ອງ.
● ການປ້ອງກັນການປົນເປື້ອນ impurity: ການອອກແບບທີ່ເຫມາະສົມແລະການນໍາໃຊ້ nozzles ສາມາດຊ່ວຍປ້ອງກັນການປົນເປື້ອນ impurity ໃນລະຫວ່າງການຂະບວນການ epitaxy ໄດ້. ການອອກແບບ nozzle ທີ່ເຫມາະສົມຫຼຸດຜ່ອນຄວາມເປັນໄປໄດ້ຂອງ impurities ພາຍນອກເຂົ້າໄປໃນເຕົາປະຕິກອນ, ຮັບປະກັນຄວາມບໍລິສຸດແລະຄຸນນະພາບຂອງຊັ້ນ epitaxial.
ໂຄງສ້າງ CVD SIC CRYSTAL COATING FILM:
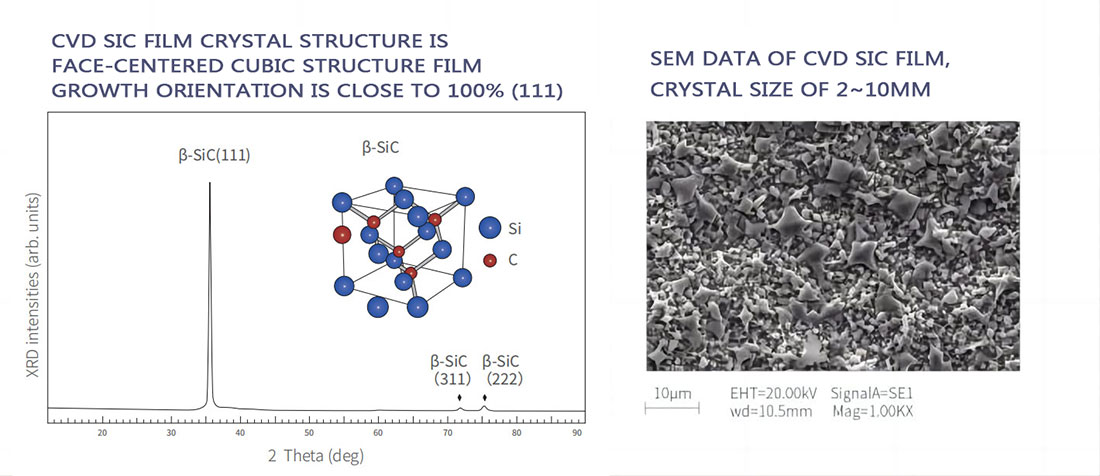
ຄຸນສົມບັດທາງກາຍະພາບພື້ນຖານຂອງການເຄືອບ CVD SiC:
| ຄຸນສົມບັດທາງກາຍະພາບພື້ນຖານຂອງການເຄືອບ CVD SiC | |
| ຊັບສິນ | ຄ່າປົກກະຕິ |
| ໂຄງປະກອບການໄປເຊຍກັນ | FCC βໄລຍະ polycrystalline, ສ່ວນໃຫຍ່ແມ່ນ (111) ຮັດກຸມ |
| ຄວາມຫນາແຫນ້ນຂອງເຄືອບ SiC | 3.21 g/cm³ |
| ຄວາມແຂງ | ຄວາມແຂງຂອງ Vickers 2500 (ໂຫຼດ 500g) |
| ເມັດ SiZe | 2-10 ມມ |
| ຄວາມບໍລິສຸດທາງເຄມີ | 99.99995% |
| ຄວາມອາດສາມາດຄວາມຮ້ອນ | 640 J·kg-1· ຄ-1 |
| ອຸນຫະພູມ sublimation | 2700℃ |
| ຄວາມເຂັ້ມແຂງ Flexural | 415 MPa RT 4 ຈຸດ |
| ໂມດູລຂອງໜຸ່ມ | 430 Gpa 4pt ໂຄ້ງ, 1300 ℃ |
| ການນໍາຄວາມຮ້ອນ | 300W·m-1· ຄ-1 |
| ການຂະຫຍາຍຄວາມຮ້ອນ (CTE) | 4.5×10-6K-1 |
VeTekSemຫົວສີດເຄືອບ CVD SiCຮ້ານຜະລິດ:

![]()

![]()













